Meskipun wafer silikon dan kaca sama-sama memiliki tujuan untuk "dibersihkan," tantangan dan mode kegagalan yang mereka hadapi selama pembersihan sangat berbeda. Perbedaan ini muncul dari sifat material dan persyaratan spesifikasi yang melekat pada silikon dan kaca, serta "filosofi" pembersihan yang berbeda yang didorong oleh aplikasi akhir mereka.
Pertama, mari kita klarifikasi: Apa sebenarnya yang kita bersihkan? Kontaminan apa saja yang terlibat?
Kontaminan dapat diklasifikasikan menjadi empat kategori:
-
Kontaminan Partikel
-
Debu, partikel logam, partikel organik, partikel abrasif (dari proses CMP), dll.
-
Kontaminan ini dapat menyebabkan cacat pola, seperti korsleting atau sirkuit terbuka.
-
-
Kontaminan Organik
-
Termasuk residu photoresist, aditif resin, minyak kulit manusia, residu pelarut, dll.
-
Kontaminan organik dapat membentuk lapisan penghalang yang menghambat proses etsa atau implantasi ion dan mengurangi daya rekat lapisan tipis lainnya.
-
-
Kontaminan Ion Logam
-
Besi, tembaga, natrium, kalium, kalsium, dan lain-lain, yang sebagian besar berasal dari peralatan, bahan kimia, dan kontak manusia.
-
Dalam semikonduktor, ion logam adalah kontaminan "mematikan", yang memperkenalkan tingkat energi di pita terlarang, yang meningkatkan arus bocor, memperpendek masa hidup pembawa muatan, dan sangat merusak sifat-sifat listrik. Dalam kaca, ion logam dapat memengaruhi kualitas dan daya rekat lapisan tipis berikutnya.
-
-
Lapisan Oksida Alami
-
Untuk wafer silikon: Lapisan tipis silikon dioksida (Oksida Alami) terbentuk secara alami di permukaan di udara. Ketebalan dan keseragaman lapisan oksida ini sulit dikendalikan, dan harus dihilangkan sepenuhnya selama fabrikasi struktur kunci seperti oksida gerbang.
-
Untuk wafer kaca: Kaca itu sendiri adalah struktur jaringan silika, jadi tidak ada masalah "menghilangkan lapisan oksida alami". Namun, permukaannya mungkin telah dimodifikasi karena kontaminasi, dan lapisan ini perlu dihilangkan.
-

I. Tujuan Utama: Perbedaan Antara Kinerja Listrik dan Kesempurnaan Fisik
-
Lempengan Silikon
-
Tujuan utama pembersihan adalah untuk memastikan kinerja listrik. Spesifikasi biasanya mencakup jumlah dan ukuran partikel yang ketat (misalnya, partikel ≥0,1μm harus dihilangkan secara efektif), konsentrasi ion logam (misalnya, Fe, Cu harus dikontrol hingga ≤10¹⁰ atom/cm² atau lebih rendah), dan tingkat residu organik. Bahkan kontaminasi mikroskopis dapat menyebabkan korsleting sirkuit, arus bocor, atau kegagalan integritas oksida gerbang.
-
-
Kepingan Kaca
-
Sebagai substrat, persyaratan intinya adalah kesempurnaan fisik dan stabilitas kimia. Spesifikasi berfokus pada aspek makro seperti tidak adanya goresan, noda yang tidak dapat dihilangkan, dan pemeliharaan kekasaran dan geometri permukaan asli. Tujuan pembersihan terutama untuk memastikan kebersihan visual dan daya rekat yang baik untuk proses selanjutnya seperti pelapisan.
-
II. Sifat Material: Perbedaan Mendasar Antara Kristalin dan Amorf
-
Silikon
-
Silikon adalah material kristalin, dan permukaannya secara alami ditumbuhi lapisan oksida silikon dioksida (SiO₂) yang tidak seragam. Lapisan oksida ini menimbulkan risiko terhadap kinerja listrik dan harus dihilangkan secara menyeluruh dan merata.
-
-
Kaca
-
Kaca adalah jaringan silika amorf. Material dasarnya memiliki komposisi yang mirip dengan lapisan silikon oksida pada silikon, yang berarti dapat dengan cepat teretsa oleh asam fluorida (HF) dan juga rentan terhadap erosi alkali kuat, yang menyebabkan peningkatan kekasaran permukaan atau deformasi. Perbedaan mendasar ini menunjukkan bahwa pembersihan wafer silikon dapat mentolerir etsa ringan dan terkontrol untuk menghilangkan kontaminan, sedangkan pembersihan wafer kaca harus dilakukan dengan sangat hati-hati untuk menghindari kerusakan pada material dasar.
-
| Barang Pembersih | Pembersihan Wafer Silikon | Pembersihan Keping Kaca |
|---|---|---|
| Tujuan Pembersihan | Termasuk lapisan oksida alaminya sendiri | Pilih metode pembersihan: Menghilangkan kontaminan sekaligus melindungi bahan dasar. |
| Pembersihan RCA Standar | - SPM(H₂SO₄/H₂O₂): Menghilangkan residu organik/fotoresist | Alur Pembersihan Utama: |
| - SC1(NH₄OH/H₂O₂/H₂O): Menghilangkan partikel permukaan | Agen Pembersih Alkali LemahMengandung zat permukaan aktif untuk menghilangkan kontaminan organik dan partikel. | |
| - DHF(Asam fluorida): Menghilangkan lapisan oksida alami dan kontaminan lainnya | Bahan Pembersih yang Sangat Basa atau Basa SedangDigunakan untuk menghilangkan kontaminan logam atau non-volatil. | |
| - SC2(HCl/H₂O₂/H₂O): Menghilangkan kontaminan logam | Hindari HF di seluruh area | |
| Bahan Kimia Utama | Asam kuat, basa kuat, pelarut pengoksidasi | Cairan pembersih alkali lemah, diformulasikan khusus untuk menghilangkan kontaminasi ringan. |
| Alat Bantu Fisik | Air deionisasi (untuk pembilasan dengan kemurnian tinggi) | Pencucian ultrasonik, megasonik |
| Teknologi Pengeringan | Pengeringan uap Megasonik, IPA | Pengeringan lembut: Pengangkatan lambat, pengeringan uap IPA |
III. Perbandingan Larutan Pembersih
Berdasarkan tujuan dan karakteristik material yang telah disebutkan di atas, larutan pembersih untuk wafer silikon dan kaca berbeda-beda:
| Pembersihan Wafer Silikon | Pembersihan Keping Kaca | |
|---|---|---|
| Tujuan pembersihan | Penghapusan menyeluruh, termasuk lapisan oksida asli wafer. | Penghilangan selektif: menghilangkan kontaminan sambil melindungi substrat. |
| Proses tipikal | Standar RCA bersih:•SPM(H₂SO₄/H₂O₂): menghilangkan zat organik berat/fotoresist •SC1(NH₄OH/H₂O₂/H₂O): penghilangan partikel alkali •DHF(HF encer): menghilangkan lapisan oksida alami dan logam •SC2(HCl/H₂O₂/H₂O): menghilangkan ion logam | Alur pembersihan karakteristik:•Pembersih alkali ringandengan surfaktan untuk menghilangkan zat organik dan partikel •Pembersih asam atau netraluntuk menghilangkan ion logam dan kontaminan spesifik lainnya •Hindari HF selama proses berlangsung. |
| Bahan kimia utama | Asam kuat, oksidator kuat, larutan basa | Pembersih alkali ringan; pembersih khusus netral atau sedikit asam. |
| Bantuan fisik | Megasonik (pembersihan partikel yang efisien dan lembut) | Ultrasonik, megasonik |
| Pengeringan | pengeringan marangoni; Pengeringan uap IPA | Pengeringan tarikan lambat; pengeringan uap IPA |
-
Proses Pembersihan Wafer Kaca
-
Saat ini, sebagian besar pabrik pengolahan kaca menggunakan prosedur pembersihan berdasarkan karakteristik material kaca, yang terutama mengandalkan bahan pembersih alkali lemah.
-
Karakteristik Bahan Pembersih:Bahan pembersih khusus ini biasanya bersifat basa lemah, dengan pH sekitar 8-9. Biasanya mengandung surfaktan (misalnya, alkil polioksietilen eter), zat pengkelat logam (misalnya, HEDP), dan bahan pembantu pembersih organik, yang dirancang untuk mengemulsi dan menguraikan kontaminan organik seperti minyak dan sidik jari, sekaligus meminimalkan korosivitas terhadap matriks kaca.
-
Alur Proses:Proses pembersihan tipikal melibatkan penggunaan konsentrasi tertentu dari bahan pembersih alkali lemah pada suhu mulai dari suhu ruangan hingga 60°C, dikombinasikan dengan pembersihan ultrasonik. Setelah dibersihkan, wafer menjalani beberapa langkah pembilasan dengan air murni dan pengeringan lembut (misalnya, pengeringan perlahan atau pengeringan uap IPA). Proses ini secara efektif memenuhi persyaratan wafer kaca untuk kebersihan visual dan kebersihan umum.
-
-
Proses Pembersihan Wafer Silikon
-
Untuk pemrosesan semikonduktor, wafer silikon biasanya menjalani pembersihan RCA standar, yang merupakan metode pembersihan yang sangat efektif dan mampu mengatasi semua jenis kontaminan secara sistematis, sehingga memastikan terpenuhinya persyaratan kinerja listrik untuk perangkat semikonduktor.
-
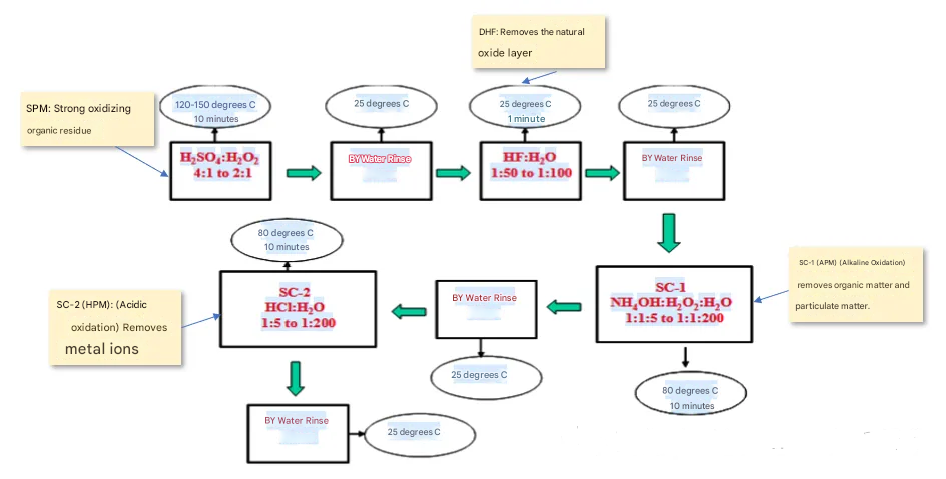
IV. Ketika Kaca Memenuhi Standar “Kebersihan” yang Lebih Tinggi
Ketika wafer kaca digunakan dalam aplikasi yang membutuhkan jumlah partikel dan kadar ion logam yang ketat (misalnya, sebagai substrat dalam proses semikonduktor atau untuk permukaan pengendapan film tipis yang sangat baik), proses pembersihan intrinsik mungkin tidak lagi mencukupi. Dalam hal ini, prinsip pembersihan semikonduktor dapat diterapkan, dengan memperkenalkan strategi pembersihan RCA yang dimodifikasi.
Inti dari strategi ini adalah untuk mengurangi dan mengoptimalkan parameter proses RCA standar agar sesuai dengan sifat sensitif kaca:
-
Penghilangan Kontaminan Organik:Larutan SPM atau air ozon yang lebih ringan dapat digunakan untuk menguraikan kontaminan organik melalui oksidasi yang kuat.
-
Penghilangan Partikel:Larutan SC1 yang sangat encer digunakan pada suhu yang lebih rendah dan waktu perawatan yang lebih singkat untuk memanfaatkan efek tolakan elektrostatik dan pengikisan mikro guna menghilangkan partikel, sekaligus meminimalkan korosi pada kaca.
-
Penghilangan Ion Logam:Larutan SC2 yang diencerkan atau larutan asam klorida encer/asam nitrat encer sederhana digunakan untuk menghilangkan kontaminan logam melalui khelasi.
-
Larangan Ketat:DHF (di-ammonium fluoride) harus benar-benar dihindari untuk mencegah korosi pada substrat kaca.
Dalam keseluruhan proses yang dimodifikasi, penggabungan teknologi megasonik secara signifikan meningkatkan efisiensi penghilangan partikel berukuran nano dan lebih lembut pada permukaan.
Kesimpulan
Proses pembersihan wafer silikon dan kaca merupakan hasil tak terhindarkan dari rekayasa balik berdasarkan persyaratan aplikasi akhir, sifat material, serta karakteristik fisik dan kimianya. Pembersihan wafer silikon bertujuan mencapai "kebersihan tingkat atom" untuk kinerja listrik, sementara pembersihan wafer kaca berfokus pada pencapaian permukaan fisik yang "sempurna dan tidak rusak". Karena wafer kaca semakin banyak digunakan dalam aplikasi semikonduktor, proses pembersihannya pasti akan berkembang melampaui pembersihan alkali lemah tradisional, mengembangkan solusi yang lebih canggih dan disesuaikan seperti proses RCA yang dimodifikasi untuk memenuhi standar kebersihan yang lebih tinggi.
Waktu posting: 29 Oktober 2025
